一.Flip Chip是什么?
Flip Chip不是一种特定的封装(比如SOIC)或者一种封装类型(比如BGA)。Flip Chip 描述的是die和package carrier电学连接的一种方法。Package carrier ,指的是substrate或者leadframe,提供从die到封装外面的连接。在“标准”的封装中(上一节讲的封装方式,Wire Bond),die和carrier之间的互联使用的是线。die连接在carrier的上面,首先,线连接到die上,然后再连接到carrier上。线通常有1-5mm长,直径15-35um。
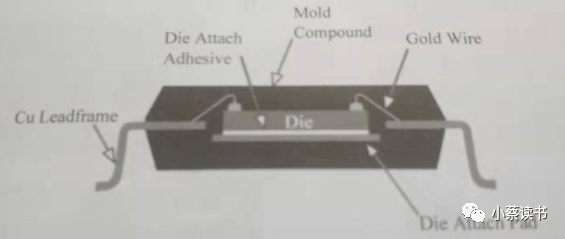
相比之下,flip chip封装的die和carrier之间的互联是通过导电的bump,bump直接放置在die的表面。然后带bump的die翻转朝下放置,bump和carrier直接连接。bump通常60-100um高,直径80-125um。

二.Flip Chip工艺流程
Wafer Clean
浅绿色代表最后的金属pad(一般为Al),蓝色代表钝化层。

2.Sputter UBM
为了让金属pad与bump更好连接。

3.Photo-resist&UBM etch
形成UBM图形

4.Print solder paste &reflow
沉积锡浆,然后回流形成bump
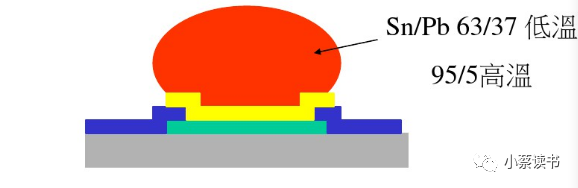
5.Inspection
检查bump的高度、电阻等
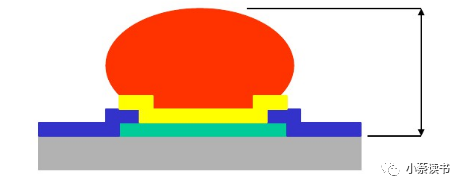
6. Flip Chip flow
后面的流程有好几种,下面是其中的一种

三.Flip Chip的优点
上篇已经讲了wire bond类型的封装,为啥还需要flip chip形式的封装,这种封装的优点有哪些呢?
1.减小了信号的电感:因为信号线的路径大大减小。在高速通信和转换器件中这是很重要的。
2.减小了电源/地的电感:通过使用flip chip互联,电源可以直接带到die的core区域,而不是必须要通过线连接到边界。这样大大减小了core电源的噪声,提升了die的性能。
3.更高的信号密度:die的整个表面都可以用来做互联,而不是仅仅只有边界。
4.die shrink:对于pad 限制的die,die可以减少面积,节约成本。
5.减小封装的面积:没有连线空间的额外需求和使用更高密度的substrate技术。
如果你觉得文章有用,请点个在看,如果能转发一下就更好了,谢谢!






